еҸ°иҝӣ科жҠҖпјҡж·ұиҖ•еҚҠеҜјдҪ“жҷ¶еңҶзә§еЎ‘е°ҒжҠҖжңҜ еҠ©еҠӣеӣҪдә§й«ҳз«Ҝе°ҒиЈ…иҮӘдё»еҸҜжҺ§
иҝ‘е№ҙжқҘпјҢе…ЁзҗғеҚҠеҜјдҪ“дә§дёҡеҗ‘й«ҳйӣҶжҲҗеәҰгҖҒй«ҳжҖ§иғҪгҖҒй«ҳеҸҜйқ ж–№еҗ‘еҠ йҖҹеҚҮзә§пјҢе…Ҳиҝӣе°ҒиЈ…жҲҗдёәиҠҜзүҮжҖ§иғҪзӘҒз ҙзҡ„е…ій”®зҺҜиҠӮгҖӮжҷ¶еңҶзә§е°ҒиЈ…пјҲWLPпјүгҖҒжүҮеҮәеһӢе°ҒиЈ…пјҲFOWLPпјүгҖҒChipletејӮжһ„йӣҶжҲҗзӯүжҠҖжңҜеҝ«йҖҹжҷ®еҸҠпјҢеҜ№е°ҒиЈ…иЈ…еӨҮзҡ„зІҫеҜҶжҺ§еҲ¶гҖҒеә”еҠӣз®ЎзҗҶгҖҒеЎ«е……еқҮеҢҖжҖ§жҸҗеҮәжӣҙй«ҳиҰҒжұӮгҖӮйқўеҜ№иЎҢдёҡжҠҖжңҜ瓶йўҲпјҢдёңиҺһеёӮеҸ°иҝӣзІҫеҜҶ科жҠҖжңүйҷҗе…¬еҸёжҢҒз»ӯиҒҡз„ҰеҚҠеҜјдҪ“зІҫеҜҶе°ҒиЈ…иЈ…еӨҮйўҶеҹҹпјҢд»ҘиҮӘдё»з ”еҸ‘дёҺдә§еӯҰз ”еҚҸеҗҢеҲӣж–°дёәж ёеҝғеҠЁеҠӣпјҢдёҚж–ӯзӘҒз ҙе…ій”®жҠҖжңҜпјҢжҺЁеҠЁй«ҳз«ҜеЎ‘е°ҒиЈ…еӨҮеӣҪдә§еҢ–жӣҝд»ЈгҖӮ

еҸ°иҝӣ科жҠҖжҲҗз«ӢдәҺ 2021 е№ҙ 2 жңҲпјҢдё“жіЁдәҺеҚҠеҜјдҪ“иҠҜзүҮе°ҒиЈ…жөӢиҜ•й…ҚеҘ—зІҫеҜҶжЁЎе…·дёҺиҮӘеҠЁеҢ–иЈ…еӨҮзҡ„з ”еҸ‘гҖҒз”ҹдә§дёҺй”Җе”®пјҢе…¬еҸёе»әзӯ‘йқўз§Ҝи¶…30000е№іж–№зұігҖӮе…¬еҸёе»әз«ӢдәҶе®Ңе–„зҡ„иҙЁйҮҸз®ЎзҗҶдҪ“зі»пјҢе·ІйҖҡиҝҮISO9001иҙЁйҮҸз®ЎзҗҶдҪ“зі»и®ӨиҜҒпјҢе…ҲеҗҺиҚЈиҺ·еӣҪ家й«ҳж–°жҠҖжңҜдјҒдёҡгҖҒе№ҝдёңзңҒдё“зІҫзү№ж–°дёӯе°ҸдјҒдёҡгҖҒеҲӣж–°еһӢдёӯе°ҸдјҒдёҡгҖҒеёӮзә§е·ҘзЁӢжҠҖжңҜз ”з©¶дёӯеҝғзӯүиө„иҙЁпјҢе·ІеҸ‘еұ•жҲҗдёәеӣҪеҶ…еҚҠеҜјдҪ“жҷ¶еңҶзә§еЎ‘е°ҒиЈ…еӨҮйўҶеҹҹзҡ„ж ёеҝғдјҒдёҡгҖӮ


е…¬еҸёеқҡжҢҒеҲӣж–°й©ұеҠЁеҸ‘еұ•пјҢжһ„е»әдәҶе®Ңе–„зҡ„з ”еҸ‘дҪ“зі»дёҺзІҫеҜҶеҲ¶йҖ иғҪеҠӣгҖӮзӣ®еүҚе»әжңү1000е№іж–№зұізӢ¬з«Ӣз ”еҸ‘еҹәең°пјҢеҢ…еҗ«з ”еҸ‘е®ӨгҖҒзІҫеҜҶе®һйӘҢе®ӨгҖҒеҸҜйқ жҖ§жөӢиҜ•е®ӨзӯүеҠҹиғҪеҢәеҹҹпјҢй…ҚеӨҮеҫ·еӣҪи”ЎеҸёдёүеқҗж ҮжөӢйҮҸд»ӘгҖҒж—Ҙжң¬е°јеә·2.5ж¬Ўе…ғжөӢйҮҸд»ӘгҖҒжҠ•еҪұд»ӘгҖҒе·Ҙе…·жҳҫеҫ®й•ңзӯүй«ҳзІҫеәҰжЈҖжөӢи®ҫеӨҮпјҢеҪўжҲҗвҖңи®ҫи®ЎвҖ”д»ҝзңҹвҖ”иҜ•еҲ¶вҖ”жөӢиҜ•вҖ” йӘҢиҜҒвҖқе…ЁжөҒзЁӢз ”еҸ‘й“ҫжқЎпјҢзЎ®дҝқдә§е“ҒжҖ§иғҪзЁіе®ҡеҸҜйқ пјҢж»Ўи¶іеӨҙйғЁе°ҒжөӢдјҒдёҡ规模еҢ–йҮҸдә§йңҖжұӮгҖӮ


дёәжҢҒз»ӯзӘҒз ҙй«ҳз«Ҝе°ҒиЈ…иЈ…еӨҮе…ій”®жҠҖжңҜпјҢеҸ°иҝӣ科жҠҖз§ҜжһҒејҖеұ•дә§еӯҰз ”ж·ұеәҰеҚҸеҗҢеҲӣж–°пјҢе…ҲеҗҺдёҺз”өеӯҗ科жҠҖеӨ§еӯҰгҖҒж·ұеңіеӨ§еӯҰе»әз«Ӣй•ҝжңҹзЁіе®ҡеҗҲдҪңе…ізі»гҖӮе…¶дёӯпјҢдёҺз”өеӯҗ科жҠҖеӨ§еӯҰеӣҙз»•жҷ¶еңҶзә§еЎ‘е°ҒиЈ…еӨҮз»“жһ„ејҖеҸ‘гҖҒзІҫеҜҶжҺ§еҲ¶з®—жі•гҖҒе…ій”®е·ҘиүәдјҳеҢ–гҖҒжҖ§иғҪйӘҢиҜҒжөӢиҜ•ејҖеұ•иҒ”еҗҲж”»е…іпјӣеҗҢж—¶пјҢдёҺж·ұеңіеӨ§еӯҰиҒҡз„ҰTGVзҺ»з’ғйҖҡеӯ”жҝҖе…үеҲ»иҡҖгҖҒеӨҡзү©зҗҶеңәд»ҝзңҹгҖҒй«ҳеҜҶеәҰзҺ»з’ғеҹәжқҝе…Ҳиҝӣе°ҒиЈ…е·ҘиүәиҝӣиЎҢеүҚжІҝжҠҖжңҜеёғеұҖпјҢжҺЁеҠЁе…Ҳиҝӣе°ҒиЈ…жҠҖжңҜдёҺиЈ…еӨҮж·ұеәҰиһҚеҗҲпјҢдёәдёӢдёҖд»Јй«ҳз«ҜеЎ‘е°Ғи®ҫеӨҮиҝӯд»ЈжҸҗдҫӣж ёеҝғжҠҖжңҜж”Ҝж’‘гҖӮ


дҫқжүҳиҮӘдё»з ”еҸ‘дёҺдә§еӯҰз ”еҲӣж–°жҲҗжһңпјҢе…¬еҸёжҲҗеҠҹз ”еҸ‘жүҮеҮәеһӢжҷ¶еңҶзә§и¶…и–„жҷ¶зүҮдҪҺеә”еҠӣеҺӢзј©еЎ‘е°Ғи®ҫеӨҮ并йҖҡиҝҮ科жҠҖжҲҗжһңйүҙе®ҡпјҢеҗҢжӯҘжҺЁеҮәеҚҠеҜјдҪ“иҠҜзүҮжҷ¶еңҶзә§зңҹз©әдјәжңҚй«ҳзІҫеәҰе…ЁиҮӘеҠЁеЎ‘е°ҒжңәгҖӮиҜҘдә§е“ҒзӘҒз ҙдәҶзәізұізә§зІҫеҜҶжҺ§еҲ¶гҖҒеӨҡйҖҡйҒ“зӢ¬з«ӢжҺ§жё©гҖҒе…ЁеҹҹеқҮеҺӢгҖҒдҪҺеә”еҠӣе°ҒиЈ…гҖҒй«ҳеЎ«е……ж— з©әжҙһгҖҒй«ҳзІҫеәҰи§Ҷи§үеҜ№дҪҚзӯүе…ій”®жҠҖжңҜпјҢжңүж•Ҳи§ЈеҶіи¶…и–„жҷ¶еңҶжҳ“жҚҹдјӨгҖҒеЎ«е……дёҚеқҮгҖҒеј•зәҝеҸҳеҪўгҖҒеҜ№дҪҚеҒҸе·®зӯүиЎҢдёҡз—ӣзӮ№пјҢжҳҫи‘—жҸҗеҚҮе°ҒиЈ…иүҜзҺҮдёҺдә§е“ҒеҸҜйқ жҖ§гҖӮзӣ®еүҚпјҢиҜҘзі»еҲ—дә§е“ҒеңЁеӣҪеҶ…еёӮеңәзҡ„еҚ жңүзҺҮи¶…иҝҮ20%пјҢдҪҚеұ…еӣҪеҶ…з»ҶеҲҶйўҶеҹҹеүҚеҲ—пјҢиҜҘдә§е“ҒиҒҡз„Ұй«ҳзІҫеәҰеЎ‘е°ҒиЈ…еӨҮз ”еҸ‘еҲ¶йҖ пјҢжңҚеҠЎеҚҠеҜјдҪ“е…Ҳиҝӣе°ҒжөӢе…ЁеңәжҷҜеә”з”ЁпјҢеңЁз»ҶеҲҶйўҶеҹҹеҪўжҲҗдәҶжҳҫи‘—з«һдәүдјҳеҠҝгҖӮ

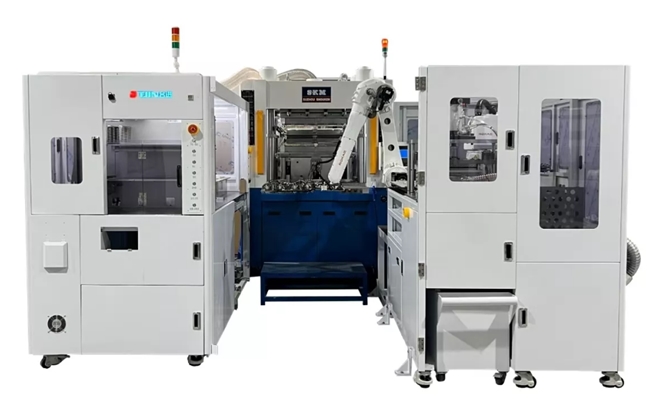
еҮӯеҖҹдјҳејӮзҡ„дә§е“ҒжҖ§иғҪдёҺзЁіе®ҡзҡ„дәӨд»ҳиғҪеҠӣпјҢеҸ°иҝӣ科жҠҖзҡ„зӣ®ж ҮеёӮеңәе·ІиҰҶзӣ–зҸ дёүи§’гҖҒй•ҝдёүи§’зӯүж ёеҝғеҚҠеҜјдҪ“дә§дёҡйӣҶзҫӨпјҢ并дёҺеҜҢеЈ«еә·гҖҒж јеҠӣгҖҒеҚҺеӨ©з§‘жҠҖгҖҒ泰科гҖҒе®үдё–еҚҠеҜјдҪ“гҖҒжҷ¶еҜјеҫ®з”өеӯҗгҖҒдәҡиҠҜеҫ®з”өеӯҗзӯүиЎҢдёҡеӨҙйғЁдјҒдёҡе»әз«Ӣй•ҝжңҹеҗҲдҪңпјҢеңЁе…Ҳиҝӣе°ҒжөӢиЈ…еӨҮйўҶеҹҹеҪўжҲҗиүҜеҘҪеҸЈзў‘дёҺеёӮеңәз«һдәүеҠӣгҖӮ2025е№ҙе…¬еҸёиҗҘдёҡ收е…ҘзӘҒз ҙ1.3дәҝе…ғпјҢеҗҢжҜ”еўһй•ҝ26.6%пјҢеҲ©ж¶ҰжҖ»йўқеҗҢжҜ”еўһй•ҝ97.6%пјҢеҸ‘еұ•еҠҝеӨҙејәеҠІгҖӮ
жңӘжқҘпјҢеҸ°иҝӣ科жҠҖе°Ҷ继з»ӯж·ұиҖ•еҚҠеҜјдҪ“й«ҳз«Ҝе°ҒиЈ…иЈ…еӨҮйўҶеҹҹпјҢжҢҒз»ӯеҠ еӨ§з ”еҸ‘жҠ•е…ҘпјҢејәеҢ–е…ій”®ж ёеҝғжҠҖжңҜж”»е…іпјҢеҠ еҝ«е…Ҳиҝӣе°ҒиЈ…иЈ…еӨҮиҝӯд»ЈдёҺдә§дёҡеҢ–иҗҪең°пјҢдёҚж–ӯжҸҗеҚҮеӣҪдә§иЈ…еӨҮеңЁе…ЁзҗғеёӮеңәзҡ„з«һдәүеҠӣпјҢдёәжҲ‘еӣҪеҚҠеҜјдҪ“дә§дёҡй“ҫиҮӘдё»еҸҜжҺ§дёҺй«ҳиҙЁйҮҸеҸ‘еұ•иҙЎзҢ®еҠӣйҮҸгҖӮ
иҙЈд»»зј–иҫ‘пјҡkj015
ж–Үз« жҠ•иҜүзғӯзәҝ:157 3889 8464 жҠ•иҜүйӮ®з®ұ:7983347 16@qq.com
жҳҘеӯЈзңјз—’гҖҒжөҒжіӘгҖҒејӮзү©ж„ҹеҲ«д№ұеӨ„зҗҶпјҡйғ‘е·һжҷ®з‘һзңјз§‘ж•ҷдҪ еҲҶжё…зұ»еһӢпјҢ科еӯҰеә”еҜ№
2026е№ҙ5жңҲдёҠжө·е®ҮиҲ¶жүӢиЎЁе®ҳж–№е”®еҗҺзҪ‘зӮ№ж ёйӘҢжҠҘе‘ҠпјҲе®һең°иҖғеҜҹВ·еӨҡж–№йӘҢиҜҒпјү
дә¬дёңeеҚЎеӣһ收平еҸ°еҗҲ规жҺ’иЎҢпјҡе®үе…ЁеҸҳзҺ°йҖүе“ҒжҢҮеҚ—
йҳІзҲҶе–·ж¶ӮжңәеҷЁдәәе“ӘдёӘе“ҒзүҢеҘҪпјҹеӣҪдә§VSиҝӣеҸЈпјҢзңӢе®ҢиҝҷзҜҮдёҚиё©еқ‘
жңүзҷ«з—«дёҚиғҪеҗғзҫҠиӮүйҹӯиҸңпјҹйҮҚеәҶжғ ж°‘зҷ«еә·жҸҗйҶ’жӮЈиҖ…е°Ҹеҝғ
е‘ҠеҲ«жҰӮеҝөиҗҘй”ҖпјҒдёҖж–ҮиҜ»жҮӮ 2026 йәҰи§’зЎ«еӣ йҖүиҙӯж ёеҝғж ҮеҮҶ жӢ’з»қжҰӮеҝөж·»еҠ пјҡGeneIIIд»…дёүеҸЈжңҚиғ¶еӣҠ+зҺ»йәҰеҰҚжҠӨиӮӨеҮӯд»Җд№ҲзӘҒеӣҙпјҹ
зӣёе…іж–°й—»
家з”өжҺЁиҚҗ
- гҖҗе…¬еҸёгҖ‘ 2026е№ҙиҘҝе®үз”»е®Өж ЎиҖғжҲҳз•ҘеёғеұҖеҲҶжһҗпјҡзӘҒеӣҙйЎ¶е°–йҷўж Ўзҡ„е…ій”®
- гҖҗе…¬еҸёгҖ‘ Ledger appеҝ…йЎ»дёӢиҪҪиҜҙжҳҺд№ҰдёҠзҡ„дәҢз»ҙз Ғ,硬件зә§дҫӣеә”й“ҫе®үе…ЁжәҜжәҗи§Јжһҗ
- гҖҗе…¬еҸёгҖ‘ и§Јз ҒиҝңжҳҺиҖҒй…’пјҡе“ҒиҙЁзӘҒеӣҙзҡ„зңҹзӣё
- гҖҗе…¬еҸёгҖ‘ д»ҺExcelеҲ°дјҒдёҡзә§ж•°еӯ—еҢ–еә•еә§пјҡйӯ”ж–№зҪ‘иЎЁеҰӮдҪ•жҠҠвҖңиҮӘеҸ‘жҺўзҙўвҖқеҸҳжҲҗвҖңеҸҜжҺ§йЎ№зӣ®вҖқ
- гҖҗе…¬еҸёгҖ‘ д»Ӣз»ҚдёҖдёӘдёҚе®№й”ҷиҝҮзҡ„еҸҜиҮӘз”ұе®ҡеҲ¶зҡ„еҫӢжүҖиө„ж–ҷз®ЎзҗҶиҪҜ件пјҢж”ҜжҢҒAIиҝҳж°ёд№…е…Қиҙ№
- гҖҗе…¬еҸёгҖ‘ 2026е…Ёзҗғ AI еӨ§жЁЎеһӢ API иҒҡеҗҲе№іеҸ°жңҚеҠЎе•Ҷпјҡи°ҒжҳҜдјҒдёҡејҖеҸ‘иҖ…зҡ„й•ҝжңҹйҰ–йҖүпјҹ
家з”өеӣҫзүҮ
ж–°й—»жҺ’иЎҢ
- 1
зӢ„иҖҗе…Ӣж·ұиҖ•йқһдҫөе…ҘејҸи„‘жңәжҺҘеҸЈпјҢз»“еҗҲи„‘з”өйҮҮйӣҶ+з®—жі•й—ӯзҺҜпјҢжү“йҖ дё»еҠЁеҒҘеә·и§ЈеҶіж–№жЎҲ
- 2
еҸ°иҝӣ科жҠҖпјҡж·ұиҖ•еҚҠеҜјдҪ“жҷ¶еңҶзә§еЎ‘е°ҒжҠҖжңҜ еҠ©еҠӣеӣҪдә§й«ҳз«Ҝе°ҒиЈ…иҮӘдё»еҸҜжҺ§
- 3
еҗҲиө„SUVе“ӘдёӘжҖ§д»·жҜ”й«ҳпјҹдёңйЈҺжң¬з”°HR-Vд»ҘиҙЁд»·жҜ”йҮҚеЎ‘еёӮеңәж јеұҖ
- 4
йҮҚзЈ…зҷ»йҷҶпјҒиұӘе®…зә§е…ЁеұӢжҷәиғҪж‘©ж №й—ӘиҖҖзұіе…°и®ҫи®Ўе‘Ё
- 5
银еҸ‘иөӣйҒ“жүҳеә• дёүд№қиөӢиғҪж·ұеҢ– жҳҶиҚҜйӣҶеӣўй•ҝжңҹжҠ•иө„д»·еҖјжё…жҷ°еҸҜжңҹ
- 6
жҲ·еӨ–з»ҸжөҺжҢҒз»ӯеҚҮжё©пјҢз« еҸ”еҸ”еҹҺеёӮзІҫиӢұжү“йҖ йҮҚеәҶжҲ·еӨ–йӨҗйҘ®жңҚеҠЎж–°иҢғејҸ
- 7
жӯҰжұүеӨ©еЈ№ж–ҮеҢ–дј еӘ’пјҡж‘ёеҫ—зқҖзҡ„еўһй•ҝе®һж•ҲпјҢзңӢеҫ—и§Ғзҡ„жң¬еңҹж·ұиҖ•
- 8
ж·ұеңізӨје“Ғеұ•пјҡжҷәиғҪжқҜеЈ¶иҝӣе…ҘвҖңй’ӣж—¶д»ЈвҖқпјҢе“Ҳе°”ж–ҜжҠўе…Ҳе®ҢжҲҗе…ЁеңәжҷҜеёғеұҖ
- 9
й—ңж–јдҪҺз©әиҫІжҘӯйӣҶеңҳжңүйҷҗе…¬еҸёжӯЈејҸжҲҗз«ӢжҡЁе•“еӢ• IPO дёҠеёӮжҲ°з•ҘиҰҸеҠғзҡ„жұәе®ҡ
- 10
йҮҢзЁӢзў‘ж—¶еҲ»пјҒйҰ–еҸ°е…Ёе…үеЎ‘жүӢжңҜеңҶж»Ўе®ҢжҲҗпјҢжі°е·һиҝ‘и§Ҷзҹ«жӯЈиҝҲе…ҘдёӘжҖ§еҢ–е…Ёзңје®ҡеҲ¶ж–°ж—¶д»Ј









